- На главную ->
- Применение ->
- Рентгеновский анализ тонких пленок
Рентгеновский анализ тонких пленок
Рентгеновский дифракционный анализ для измерения параметров решетки эпитаксиальных структур
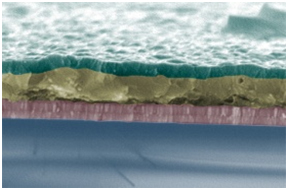
Рентгеновская дифракция является особенно ценным методом для исследования эпитаксиальных структур и других тонкопленочных материалов. Используя точные методы измерения параметров решетки, она позволяет с большой точностью выявить несоответствие решетки эпитаксиальной структуры и подложки, на которой она была выращена. Соответствие и несоответствие этих параметров является важным свойством устройств, в основе которых лежат эпитаксиальные структуры (эпитаксиальные пленки), Например, магнитные гранатовые пленки для элементов памяти, легированные пленки GaAs для светодиодов и высокоскоростных транзисторов, инфракрасные детекторы и другие важные продукты микроэлектроники. Еще одним интересным применением для рентгеновской дифракции XRD тонких пленок является то, что коэффициент теплового расширения может быть определен путем построения графика параметров решетки в зависимости от температуры с помощью температурной приставки для рентгеновского дифрактометра.
© 1959—2023 TOKYO BOEKI.
All Rights Reserved.








