- На главную ->
- Применение ->
- Рентгеновская рефлектометрия
Рентгеновская рефлектометрия
Толщина, плотность и шероховатость многослойных структур (многослойных пленок) на полупроводниковых подложках
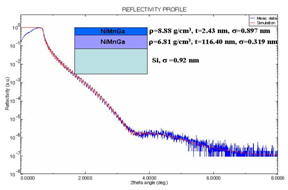
Анализ методом рентгеновской рефлектометрии тонких пленок используется для определения толщины, плотности и шероховатости для одно- и многослойных структур на полупроводниковых пластинах, и может быть выполнен как для кристаллических, так и аморфных материалов. Метод рентгеновской рефлектометрии основан на измерении отражательной способности рентгеновских лучей поверхностью материала вблизи угла полного внешнего отражения (ПВО) θc. Этот угол чрезвычайно мал и называется критическим углом. Угол изменяется в зависимости от электронной плотности материала. Чем выше угол падающего рентгеновского пучка по отношению к критическому углу, тем глубже рентгеновские лучи проникают в материал. Для материалов, поверхность которых можно считать идеально плоской, отражательная способность внезапно уменьшается под углами выше критического угла в пропорции θ-4.
Если поверхность материала шероховатая, это вызывает более резкое снижение отражательной способности. Если такой материал, используется в качестве подложки, равномерно порытой слоем другого материала, имеющего отличную электронную плотность, то отражения рентгеновских лучей от поверхности раздела между подложкой и тонкой пленкой и от свободной поверхности тонкой пленки будут либо усиливаться либо ослабляться интерферируя друг с другом, образуя осцилляционный рисунок. В первом приближении, интенсивность рассеянная образцом пропорциональна квадрату модуля Фурье преобразования электронной плотности. Таким образом, профиль плотности электронов можно вывести из измеренной интенсивности, а затем могут быть определены вертикальные характеристики (толщины слоев), а также латеральные характеристики (шероховатость и корреляционные свойства на границах пленок), характеризующие многослойные структуры. В частности, толщина пленки может быть определена из периодичности колебаний и информации о поверхности и границах пленок по угловой зависимости амплитуды колебаний.
© 1959—2023 TOKYO BOEKI.
All Rights Reserved.








